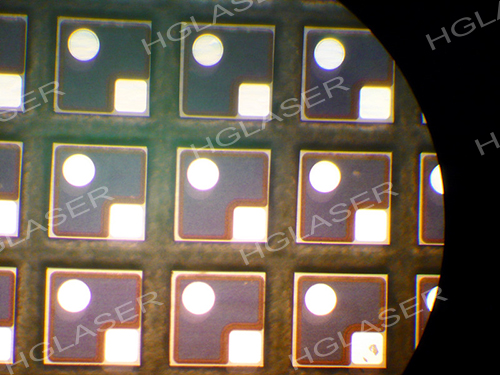
华工激光自主研发的红外激光晶圆划片机LDC-5142具有国际先进水平,采用1064nm红外激光作为切割工具,切割线条质量优越,无接触式加工避免加工产生应力,可以提高晶粒的切割质量和效率,切割后的芯片具有优良的电学特性。该机具有划片速度快、操作便捷、维护成本低等优点,适用于半导体制造行业单台面玻璃钝化二极管晶圆的切割划片。
● 切割速度快,对于单台面玻璃钝化二极管晶圆的切割速度达到了150mm/s,是传统刀片划片机正切速度的15-20倍、背切速度的3-5倍;
● 加工品质高,光束质量好,适用于精密、精细划片,切割过程无机械应力产生,有效减少芯片背崩及微裂纹;
● 运行成本低,平均无故障使用时间可达10万小时,电光转换效率高,设备功率低于2KW,长期使用可为用户节省大量的能耗支出;
● 操作简便,自主知识产权的操作软件,功能强大,能对40mm以下的正方形芯片图像识别自动对位切割。
华工激光LHR300D红外激光晶圆划片机主要应用于半导体制造行业单台面玻璃钝化二极管晶圆的切割划片。
| 名称 | 红外激光晶圆划片机 |
|---|---|
| 波长 | 1064nm |
| 激光功率 | 20W |
| 定位精度 | ±4μm |
| XY光栅尺分辨率 | 0.1μm |
| Z轴精度 | ±1μm |
| 旋转轴精度 | ±20″ |
| CCD定位精度 | 1-2μm |
| 重复定位精度 | ±1μm |
| 工作台有效行程 | 250mm×250mm |
| 最大切割尺寸 | 4英寸 |
| 切割线宽 | 30-50μm |
| 切割深度 | 80-120μm |
| 切割速度 | 1-150mm/s |
备注:本公司保留对上述参数更改的权利。若您对机器有特殊要求,我们可专门定制,欢迎来电洽谈。