短波红外(SWIR)成像技术:重塑先进封装检测的精度与效率
浏览量(192)

现代先进封装集成了多芯片堆叠、硅通孔(TSV)、微凸点(Micro-bump)等极细微结构,其检测难点主要体现在:
缺陷隐匿化:空洞、分层、微裂纹等关键缺陷往往深埋于多层材料内部,令传统光学手段难以触达。 材料穿透需求:需在不损伤敏感电路的前提下,实现对硅基底、陶瓷及聚合物等多种不透明材料的深度穿透成像。 精度与产能的平衡:既需捕捉微米级细微缺陷,又需满足量产环境下大面积、高通量的快速扫描需求。 界面状态可视化:铜-铜(Cu-Cu)键合界面的质量、介质层粘接的均匀性等,直接决定了器件的电性能与长期可靠性。


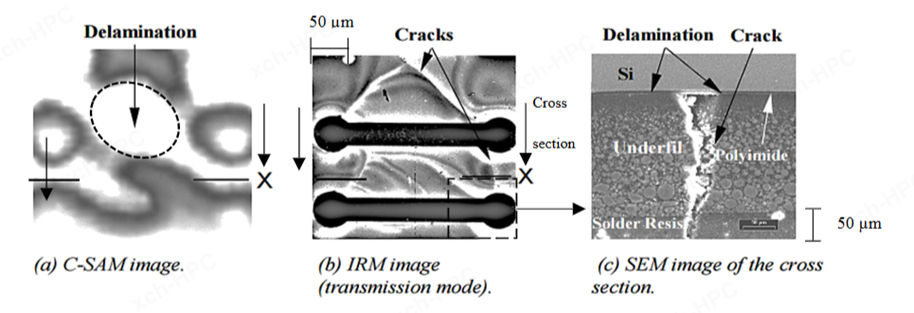

短波红外(SWIR)通常指波长在900 nm-1700 nm的电磁波,基于独特的物理特性,SWIR正成为先进封装检测的变革性利器:
卓越的硅穿透能力:硅材料在SWIR波段具有良好的透光性,允许光子穿透基板,实现对背面金属层、TSV及键合界面的非破坏性视觉检测。 高对比度材料区分:铜、硅、氧化物及聚合物在SWIR波段的光学特征差异显著,能够清晰勾勒出微米级的内部缺陷轮廓。 无损非接触检测:作为非电离辐射成像,SWIR对器件无物理或电学损伤,完美适配在线(In-line)及在片(On-wafer)检测场景。 高效全场扫描:配合高灵敏度铟镓砷(InGaAs)相机,可实现高速、大画幅成像,从而严丝合缝地嵌入量产节拍。

混合键合(Hybrid Bonding)质量评估:直接观测铜凸点对齐度与介质层键合完整性,识别微空洞及污染,为工艺调优提供即时反馈。
TSV与硅内互连可视化:穿透硅衬底监控TSV填充质量及内部裂纹,评估3D堆叠结构的机械稳定性。
背面工艺(Backside Processing)监控:指在减薄、背面金属化工艺后,对划痕、残余应力及层间套刻精度进行的非破坏性检查。
键合能量(Bonding Energy)定量分析:在W2W(晶圆对晶圆)场景下,利用
高精度红外对准:在键合过程中,利用SWIR实现亚微米级的跨材料层对准,显著提升封装良率。

图2 近红外成像效果图
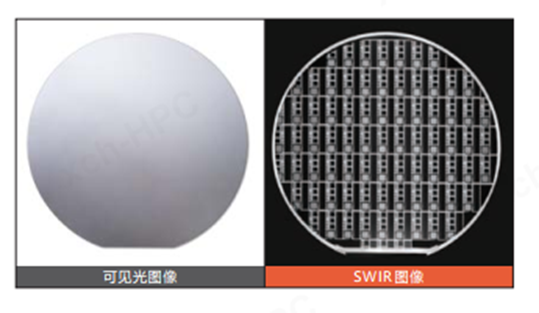
图3 空间光 vs SWIR成像效果
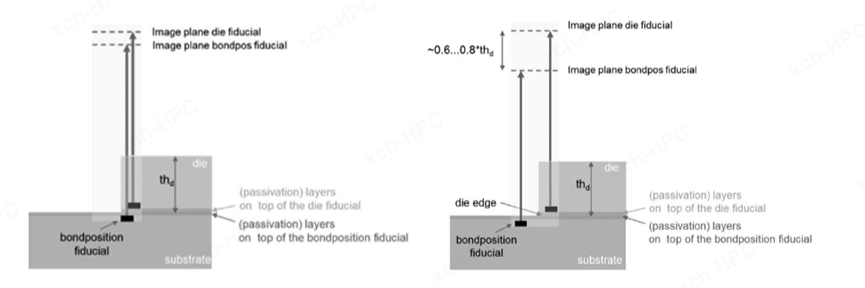
图4 近红外成像对准原理
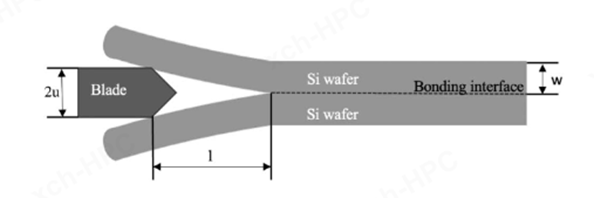
图5 晶圆键合界面结合强度的测试方法示意图(双悬臂梁DCB实验)

在实际部署中,选择何种成像模式往往取决于检测环节在生产流片中的定位。
1. 线扫相机:作为量产全检的“竞速者”,线扫相机通过与晶圆间的连续相对运动成像,专为追求极致效率的量产环境而生。
工艺契合度:完美适配12寸晶圆的全表面缺陷筛查。在减薄、抛光后,能以极高通量捕捉深埋内部的微裂纹与异物。
技术优势:
吞吐量(Throughput)最大化:消除频繁的“启-停”等待,实现近乎实时的在线检测。
图像一致性:能有效规避大面积成像时的边缘畸变,实现无缝的图像拼接,从而利于算法进行全局比对。
核心挑战:对运动平台的同步精度(Jitter)及线光源的均匀性有极严苛要求。
2. 面阵相机:精微对准与复核的“定格者”,面阵相机通过瞬时曝光捕捉高分辨率局部特征,更倾向于静态或准静态下的精密分析。
工艺契合度:专注于混合键合中的亚微米级红外对准(Alignment),以及对缺陷点的二次高倍率复检。
技术优势:
静态分辨率极限:配合高倍率显微系统,能清晰呈现铜柱连接或TSV填充的细微细节。
系统集成简易:光学调试与照明方案更具普适性,适合部署在空间受限或运动路径复杂的设备内部。
核心挑战:大面积扫描时,频繁的“步进-扫描”循环会显著牺牲产能(UPH)。

若您的目标是“全量筛查、提升良率与UPH”,线扫系统是确保产线节奏不中断的最优解;若您的目标是“极致对准、工艺调优”,则面阵系统在精度与稳定性方面更胜一筹。

图6 滨松SWIR相机产品
除了深度的技术分享,我们还为您准备了一份特别的见面礼。欢迎扫描下方二维码提前报名,届时亲临展台完成签到,即可参与温馨的现场打卡活动。 轻松一步,您就能将滨松定制精美冰箱贴带回家,并在活动结束后获取完整的滨松中国SEMICON CHINA 2026样本资料库。


分享至好友和朋友圈
免责声明:
网站内容来源于互联网、原创,由网络编辑负责审查,目的在于传递信息,提供专业服务,不代表本网站及新媒体平台赞同其观点和对其真实性负责。如因内容、版权问题存在异议的,请在 20个工作日内与我们取得联系,联系方式:021-80198330。网站及新媒体平台将加强监控与审核,一旦发现违反规定的内容,按国家法规处理,处理时间不超过24小时。




